一文了解什么是功率半导体器件产品的失效 发布时间:2025-11-07
功率半导体器件失效,指的是器件功能完全或部分丧失、参数发生显著漂移,或间歇性出现上述异常状态。无论失效是否可逆,一旦发生,该器件在实际应用中便不再具备使用条件,必须予以更换或废弃。金鉴实验室作为专注于光电半导体领域的科研检测机构,能够对功率半导体器件进行专业的失效分析,致力于为客户提供高质量的测试服务,为功率半导体器件在各个领域的可靠应用提供坚实的质量保障。

失效模式,是失效所呈现的具体形式、状态与现象,是失效在宏观层面的表现。不同种类的功率芯片,其失效模式各有差异,常见的有电极间短路、热烧毁、参数漂移等。导致器件失效的因素复杂多样。外部原因主要包括环境应力、电应力、机械应力等;内部原因则涉及衬底材料、钝化层材料、器件结构等在物理或化学层面发生的变化。这些内因是失效发生的根本所在。通常,我们可以从失效机理、失效时间特征、失效后果等维度对功率器件失效进行分类。
一、按失效机理分类
根据失效产生的内在机制,可将功率芯片失效分为结构性失效、热失效、电失效和腐蚀性失效等类型。金鉴实验室在失效测试方面具有丰富的经验,实验室拥有一支由国家级人才工程入选者和资深技术专家组成的团队,能够针对不同的失效类型提供具体的解决方案。如需专业检测服务,可联系金鉴检测顾问189-2421-3655。
1. 结构性失效指功率芯片或模块中的结构部件因材料本身问题、衬底损伤、蠕变等原因导致的失效,常见表现有疲劳断裂、磨损、结构变形等。此类失效主要与结构材料的机械特性及所受机械应力有关,有时也与热应力、电应力存在耦合关系。
2. 热失效由于器件过热或温度剧烈波动引发的烧毁、金属熔融、材料迁移或断裂等失效现象。热失效主要由热应力引起,对功率模块而言,其结构设计、基板材料选择、焊接工艺等也会显著影响其热可靠性。
3. 电失效因电流过载、电压击穿或长期电应力作用导致的器件烧毁、熔融、参数漂移或性能退化。电失效的直接诱因是电应力,但其背后往往与芯片内部缺陷、封装工艺不良等因素密切相关。
4. 腐蚀性失效器件受化学腐蚀、电化学腐蚀作用,或封装材料老化、变质所引起的失效。此类失效通常与酸碱等腐蚀性物质的侵入或残留有关,环境温湿度、外加电压等因素也会加速腐蚀过程。
二、按失效时间特征分类
根据失效发生的时间规律,可将功率器件失效分为早期失效、偶然失效和耗损失效。
1. 早期失效主要由芯片内部缺陷、封装材料缺陷或制造过程中引入的瑕疵导致。这一阶段的失效率通常较高,但可通过可靠性测试或老化筛选等手段将有缺陷的产品剔除,从而使后期失效率显著降低并趋于稳定。工程实践中,必须准确定位导致早期失效的缺陷类型及其产生路径,并采取针对性控制措施。
2. 偶然失效由随机事件引发的失效,发生概率较低且难以预测。其诱因可能包括设计裕量不足、潜在工艺缺陷、突发性应力事件或人为操作失误等。要减少偶然失效,同样需要深入分析失效根源。金鉴实验室在进行试验时,严格遵循相关标准操作,确保每一个测试环节都精准无误地符合标准要求。
3. 耗损失效因长期工作或恶劣环境导致器件性能发生不可逆退化而引发的失效。进入耗损期后,产品失效率会迅速上升。常见原因包括原子/离子迁移、界面态变化、热电效应、电化学腐蚀、材料磨损、疲劳断裂等。
三、按失效后果分类
根据失效对器件性能的影响方式,可分为参数漂移、退化失效、功能失效和间歇失效等类型。金鉴实验室拥有先进的测试设备和专业的技术团队,利用物理和化学的分析手段,从宏观和微观分析出失效原因,并为客户提出改善方向。
1. 参数漂移指器件的阈值电压、漏电流、导通电阻等关键参数发生超出规定范围的偏移,导致器件无法满足应用要求。
2. 退化失效器件的一个或多个参数随时间逐渐劣化,最终超出规范范围。这是一个渐变过程,可能由长期应力作用、材料界面互扩散、电化学腐蚀、电迁移等因素引起。
3. 功能失效器件部分或全部功能丧失,无法完成既定操作。可能由过应力冲击、性能的突然退化、腐蚀等原因导致。
4. 间歇失效器件在测试或使用过程中出现性能时好时坏的不稳定现象。可能原因包括离子污染、金属间化合物的不稳定性、应力导致的缺陷活动等。
四、案例分析
存在缺陷或性能不佳的半导体器件通常会表现出异常的局部功耗分布,最终会导致局部温度增高。金鉴显微红外热点定位系统利用新型高分辨率微观缺陷定位技术进行热点锁定(lock in) ,可快速而准确地探测细微缺陷(异常点)位置。对热点进行FIB切割分析后,可以观察到此发热点金属化薄膜铝条被熔断。
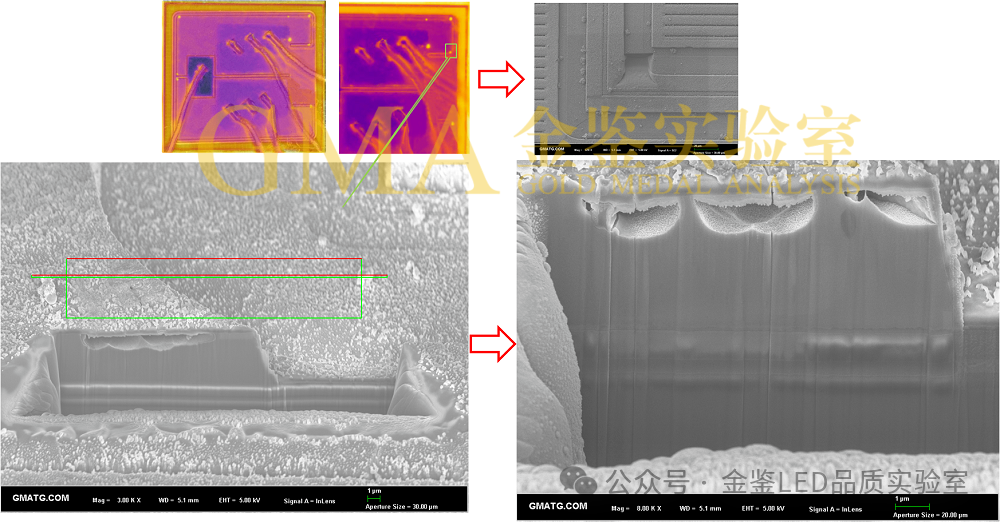
金鉴实验室的专业服务不仅限于测试和认证,还包括失效分析、技术咨询和人才培养,为客户提供一站式的解决方案,金鉴将继续秉承着专业的服务态度,不断提升自身的技术水平和服务质量,为半导体行业贡献我们的力量。
- 上一篇: 温度变化试验:原理、用途与流程解析
- 下一篇: 汽车车灯检测与可靠性验证





