电子元器件失效分析之金铝键合 发布时间:2025-10-24
电子元器件封装中的引线键合工艺,是实现芯片与外部世界连接的关键技术。其中,金铝键合因其应用广泛、工艺简单和成本低廉等优势,成为集成电路产品中常见的键合形式。金铝键合失效这种现象虽不为人所熟知,却是电子设备可靠性的一大隐患。金鉴实验室作为专注于电子元器件产业的科研检测机构,能够对电子元器件进行严格的检测,致力于为客户提供高质量的测试服务,为电子元器件在各个领域的可靠应用提供坚实的质量保障。
为什么金铝键合会失效
金铝键合失效主要表现为键合点电阻增大和机械强度下降,最终导致电路性能退化或开路。其根本原因源于金和铝两种金属的物理与化学特性差异。
1. 金属间化合物形成(IMC)当环境温度升高,金原子和铝原子开始相互扩散,在键合界面形成金属间化合物,如Au₂Al、Au₅Al₂和AuAl₂。这些化合物具有较高的电阻率,且质地脆硬。它们的形成会显著增加键合点的接触电阻,并削弱其机械强度。金鉴实验室拥有专业的IMC检测设备和技术团队,能够确保IMC形貌观测与成分分析的准确性和可靠性,如需进行专业的检测,可联系金鉴检测顾问189-2421- 3655。
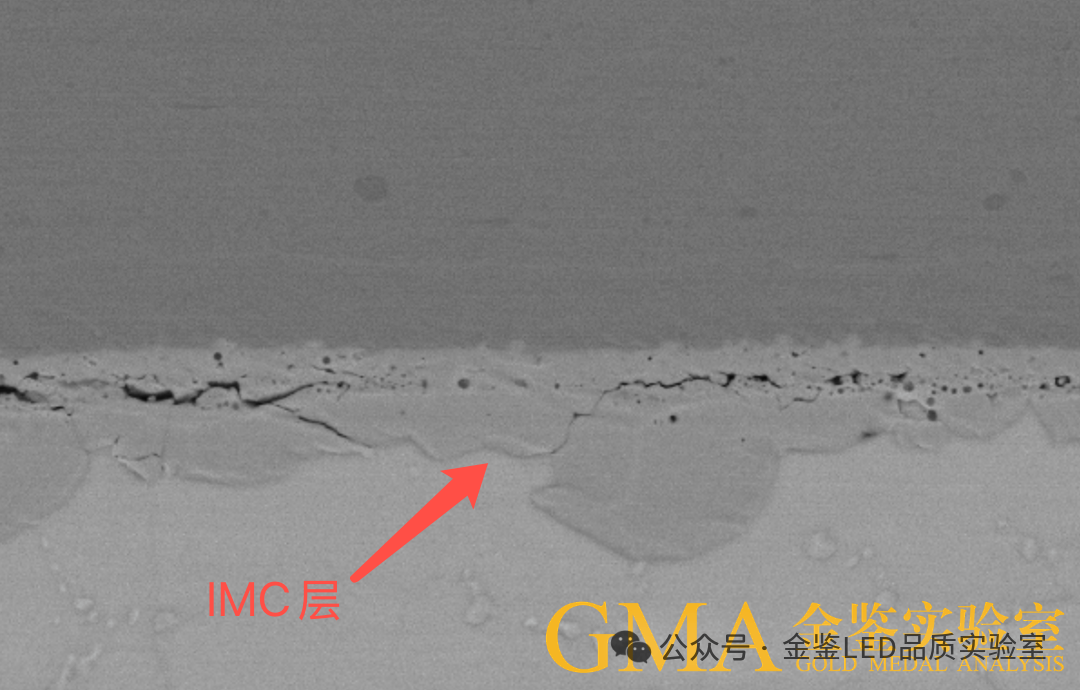
2. 柯肯德尔效应由于金原子的扩散速率远高于铝原子,这种不对等的质量迁移导致界面处形成微观空洞,即柯肯德尔空洞。空洞的汇聚和生长会减少键合点的有效接触面积,直接导致键合强度降低,直至键合点分离。金属间化合物的形成与柯肯德尔空洞的生长是相互关联的物理化学过程,共同加速了键合界面的退化。
失效的主要影响因素
1. 温度环境温度或器件工作温度是加速失效的首要因素。温度升高会显著加快原子扩散速率和化学反应速度,从而急剧缩短键合界面的使用寿命。金鉴实验室在进行试验时,严格遵循相关标准操作,确保每一个测试环节都精准无误地符合标准要求。
2. 时间金铝键合的失效是一个随时间累积的过程。即使在常规工作温度下,经过足够长的运行时间,键合界面性能的退化也会逐渐显现。
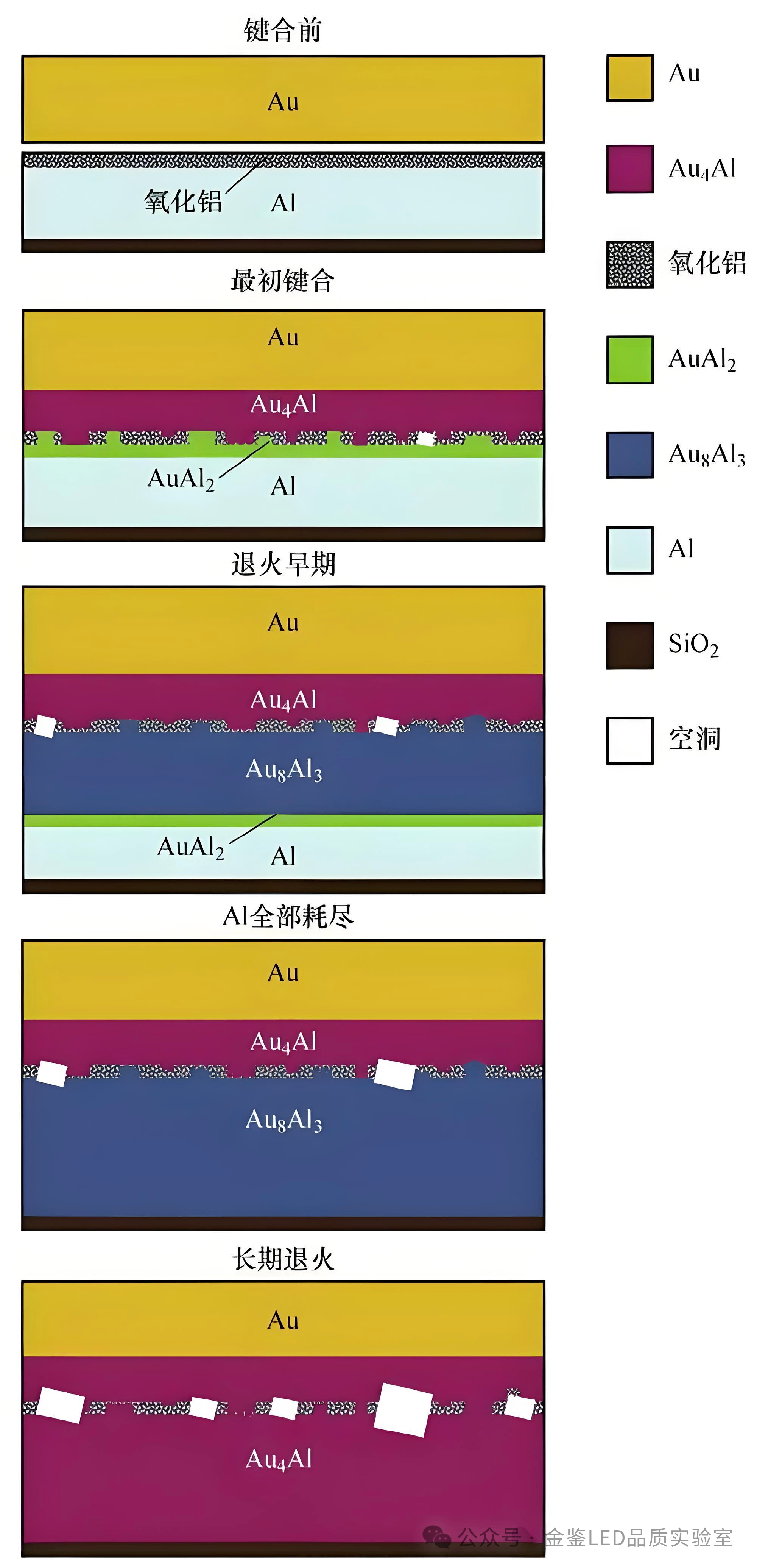
解决方案与改进措施
面对金铝键合的系统性问题,简单的工艺参数调整已无法根本解决问题。实践证明,最有效的解决方案是从材料体系入手,避免使用金铝异质键合。金鉴实验室提供专业的引线键合工艺评价服务,帮助企业评估和优化其引线键合技术,确保产品的性能和稳定性。
1. 金-金键合系统当芯片键合区为金层时,采用金丝进行键合。该组合可实现同质金属互联,界面稳定,具有最高的可靠性。
2. 铝-铝键合系统当芯片键合区为铝层时,推荐使用硅铝丝进行键合。纯铝丝机械强度不足且易氧化,添加约1%的硅元素形成的硅铝丝,在保持单一金属体系优势的同时,改善了工艺性能和机械特性。
3. 其他替代方案铜丝键合凭借其优良的导电性和机械强度,已成为中低端领域替代金丝的一种选择。但需注意,铜与铝同样属于异质金属组合,存在类似的界面反应风险,且铜丝硬度较高,对工艺控制要求更为严格。
启示与展望
金铝键合失效问题给电子元器件可靠性工程带来了重要启示:在追求工艺简便和成本控制的同时,不能忽视材料兼容性这一基础科学问题。随着电子设备向高性能、高可靠性方向发展,对键合工艺的要求也日益提高。通过材料体系的优化设计,从源头上消除金属间化合物形成的可能性,才能确保电子元器件在长期使用过程中的稳定性和可靠性。金鉴实验室的专业服务不仅限于测试和认证,还包括失效分析、技术咨询和人才培养,为客户提供一站式的解决方案,金鉴将继续秉承着专业的服务态度,不断提升自身的技术水平和服务质量,为电子元器件行业贡献我们的力量。
- 上一篇: 高浓度二氧化硫腐蚀试验
- 下一篇: 铜及铜合金的特性、应用与检测





