引线键合的三种技术 发布时间:2025-09-19
微电子封装是芯片成为功能产品的最后一步。它不仅为芯片提供电气连接、散热通道,还承担物理支撑与保护作用。封装质量直接影响器件性能,其中,互连技术尤为关键。研究表明,25%~30%的半导体失效源于芯片互连问题。金鉴实验室作为专注于芯片产业的科研检测机构,能够对芯片进行严格的检测,致力于为客户提供高质量的测试服务,为芯片在各个领域的可靠应用提供坚实的质量保障。
在各类互连方式中,引线键合因成本低、工艺成熟,仍占据封装市场约70%的份额。引线键合是一种使用细金属线,利用热、压力、超声波能量为使金属引线与基板焊盘紧密焊合,实现芯片与基板间的电气互连和芯片间的信息互通。
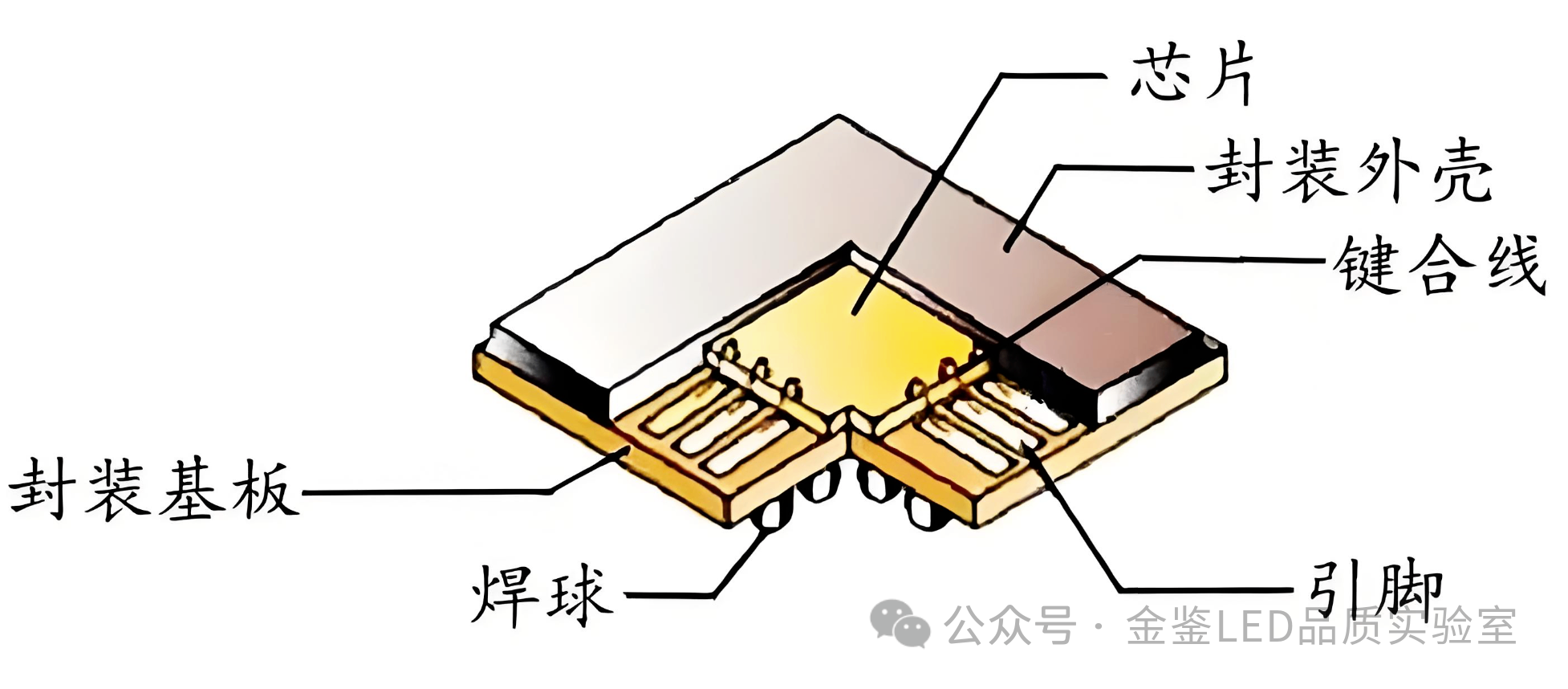
器件封装结构
金鉴实验室具备专业的测试设备,适用于分立电子器件、半导体器件和微电路封装等元件内部的键合线和芯片粘接力测量,能够对不同焊接方式的效果进行评估,帮助客户选择最佳的焊接工艺,提高焊接质量和生产效率。如需进行专业的检测,可联系金鉴检测顾问189-2421- 3655。
一、热压键合
1.原理
通过加热与加压使金球发生显著塑性变形,表面滑移线破坏氧化膜,洁净金属面接触并扩散,形成焊点。
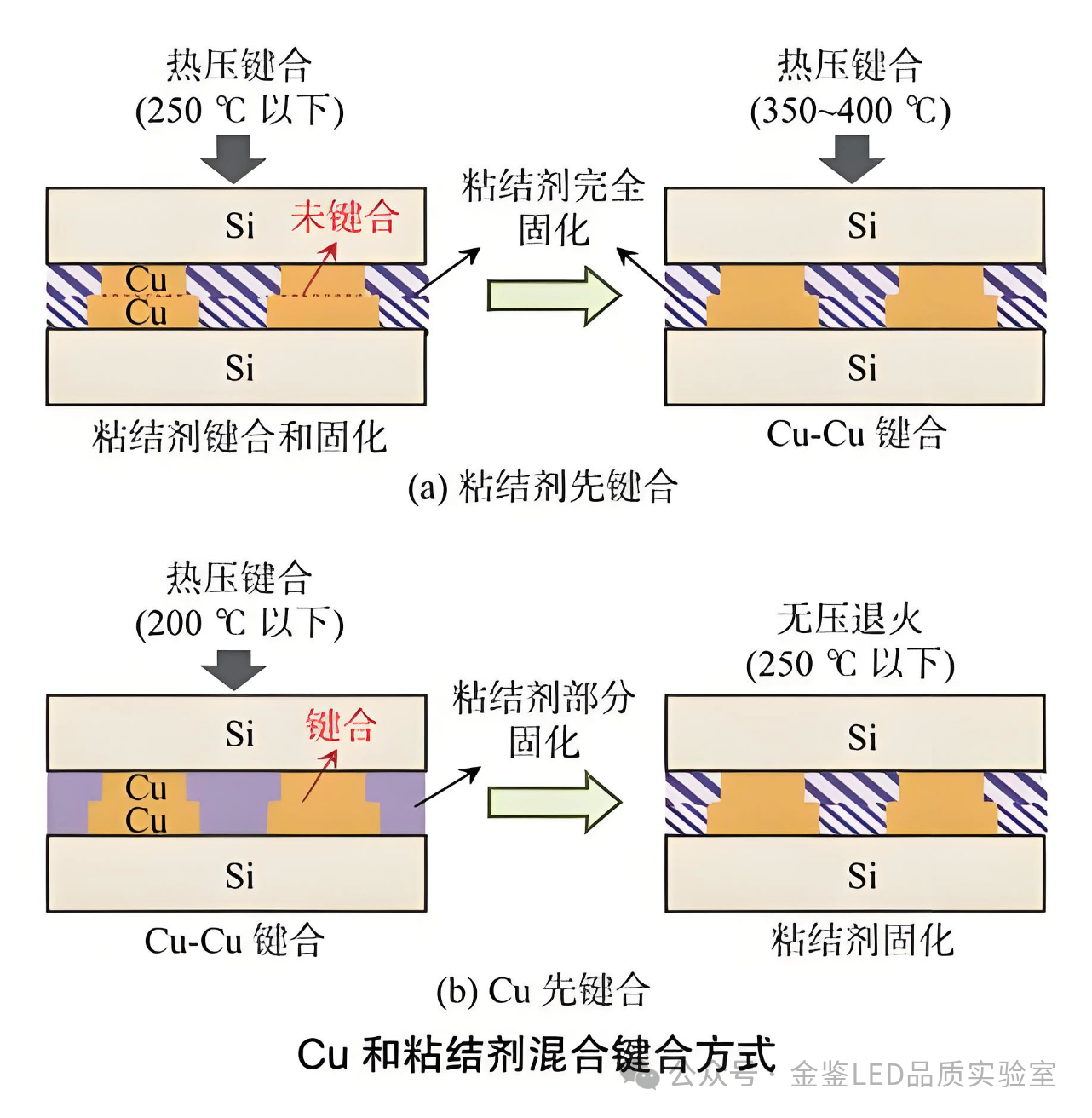
2.关键影响因素
热压键合对材料有较高要求。例如:
Au-Ag、Au-Cu等可形成固溶体的金属组合,扩散性好,焊接性能优良;
Au-Si、Al-Si等可形成低熔点共晶,也具备良好的可焊性;
而如Au-Al、Cu-Al等通过扩散形成金属间化合物的组合,虽可焊接但需严格控制工艺。
3.工艺参数:
键合时间:时间延长有助于提高变形率和连接强度;
键合力:需精确控制,过大可能损伤芯片,过小则连接不牢;
变形率:在一定范围内,拉断载荷与球的变形率成正比;
洁净度:任何污染都会显著降低焊接强度。
4.特点
优势:工艺简单,无方向性,金-金键合稳定。金鉴实验室拥有专业的测试设备和技术团队,能够确保测试的准确性和可靠性。
劣势:需高温(通常150°C以上),对洁净度极敏感,小焊盘适应性差,成品率偏低。
二、超声键合
1.原理
常温下,超声振动使氧化膜破碎,纯净金属面摩擦生热并扩散,实现连接。
过程分两段:初始滑移去污染,随后横向塑性变形完成键合。
2.关键影响因素
超声功率:决定材料软化程度;
键合力:压力越大,越早形成连接,滑动阶段缩短;
变形幅度:强度随变形增加而提升,但超过丝材承载极限时断裂;
后加热:可进一步促进扩散,提升接头强度。
3.特点
优势:可焊异种金属,不影响导电性;周期短、热影响小;无需辅料,能耗低;金属间化合物生长少,可靠性高。
劣势:对表面粗糙度敏感;铝屑易粘焊头,难清理;材料厚度受限,可焊金属范围窄;设备功率需求高。
三、热压超声键合
1.原理
结合了热压和超声两种能量的热压超声键合(又称金丝球键合),成为目前最主流的引线键合技术。它同时利用热、压力和超声波能量,在较低温度和压力下实现高质量连接。
2.典型工艺流程
穿线:引线穿过劈刀,伸出长度决定后续球尺寸;
形成球:通过EFO(电子火焰熄灭)放电将引线端部熔成球状;
对位:球移动到焊盘上方;
第一焊点:劈刀将球压到焊盘上,施加压力、温度和超声波形成连接;
拱丝成型:劈刀上升并移动到第二焊点位置,形成特定拱形;
第二焊点:在基板或引线框上形成楔形焊接;
断线:夹子闭合,劈刀上升扯断引线,准备下一次键合。
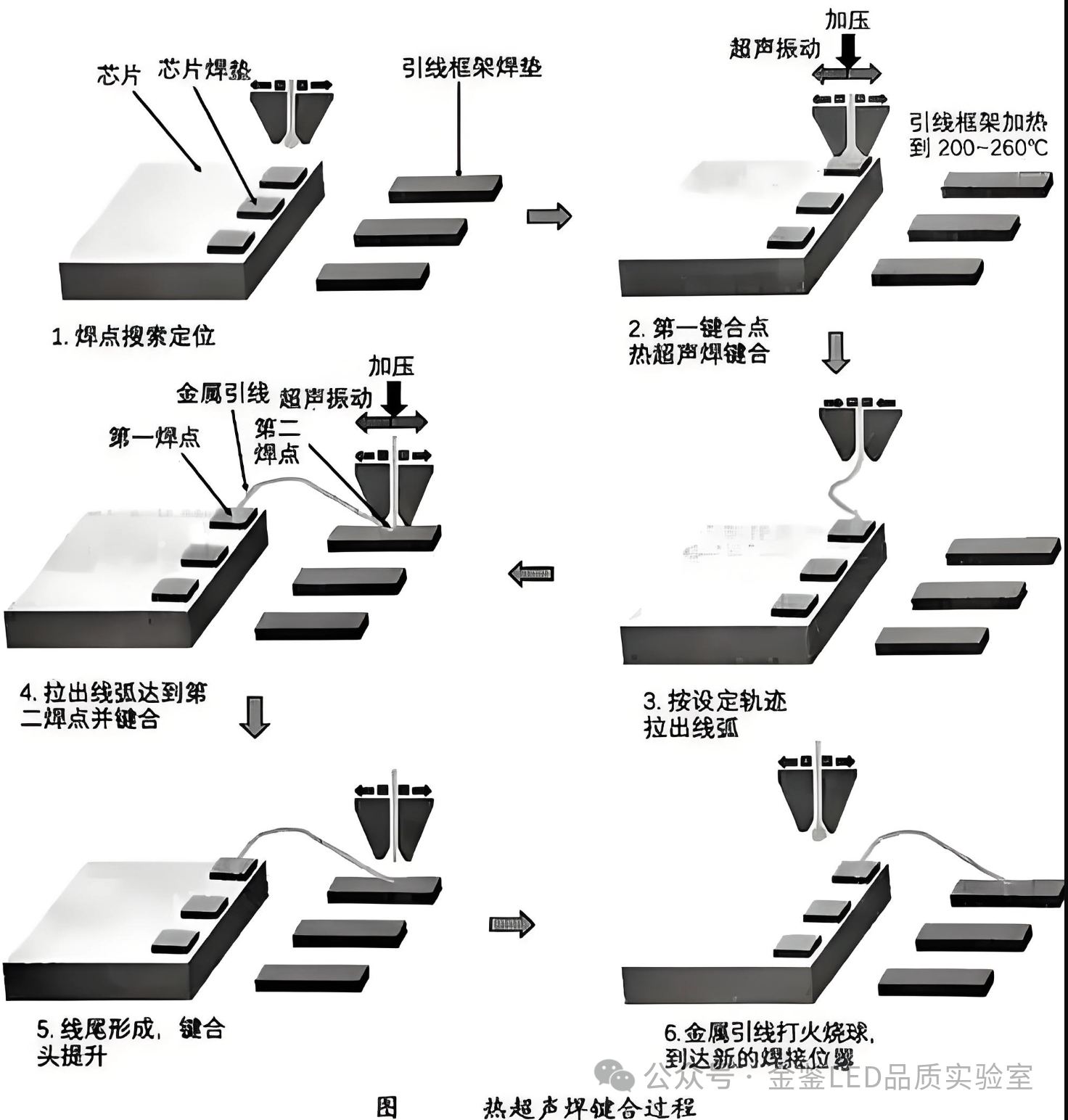
3.关键影响因素
超声时间:过长易损焊盘,过短扩散不足;
变形量:有效键合面积随变形增大而增加,强度提升。
4.特点
优势:温度与压力低于纯热压,热应力小;可形成复杂拱丝,适应高密度封装;无方向性,工艺窗口宽。
劣势:对污染物敏感,易出现缩坑;参数多(温度、压力、超声、时间),调试复杂; 焊盘尺寸略大于超声键合,成品率略低。
结语
尽管引线键合技术已成熟应用数十年,它仍在不断发展和优化。随着芯片尺寸缩小和集成度提高,对键合精度、速度和可靠性的要求越来越高。金鉴实验室提供专业的引线键合工艺评价服务,帮助企业评估和优化其引线键合技术,确保产品的性能和稳定性。
新型材料如合金丝、镀钯铜丝等逐渐应用,提高了连接可靠性和抗腐蚀性能。键合设备也越来越精密,许多现代键合机已经具备实时监测、自动校准和机器学习优化能力,能够根据焊点质量动态调整参数。
金鉴实验室的专业服务不仅限于测试和认证,还包括失效分析、技术咨询和人才培养,为客户提供一站式的解决方案,金鉴将继续秉承着专业的服务态度,不断提升自身的技术水平和服务质量,为芯片行业贡献我们的力量。
- 上一篇: 为什么金属材料要做化学成分分析?
- 下一篇: SEM与TEM该如何选择?





