FIB-SEM双束系统的工作原理与应用 发布时间:2025-09-18
聚焦离子束(Focus ion beam,FIB)结合扫描电子显微镜(Scanning electronmicroscopy,SEM)结合形成的双束系统,是现代微纳加工与表征领域的重要工具。该系统同时具备高精度加工能力和高分辨率成像功能,在材料科学、半导体工业、生物技术等领域发挥着关键作用。金鉴实验室作为专注于微纳加工与表征领域的科研检测机构,拥有专业的FIB-SEM系统,致力于为客户提供高质量的测试服务,为聚焦离子束在各个领域的可靠应用提供坚实的质量保障。
FIB-SEM发展与基本功能
1.FIB-SEM发展
从材料科学的角度来看,FIB能够以几乎无应力的方式进行超精细加工,对材料几乎没有特殊要求,因而最早在半导体行业中如光刻、光掩模维修,电路修改,故障诊断分析和样品制备等方面得到大规模应用。
由于有效解决了与聚合物、绝缘体、半导体和金属等材料有关的超精细加工问题,双束系统在材料科学领域的应用也越来越广泛,为基础研究和技术实现提供了广阔的空间。金鉴实验室拥有专业的FIB测试设备和技术团队,能够确保FIB测试的准确性和可靠性,如需进行专业的检测,可联系金鉴检测顾问188-1409-6302。
FIB 在材料科学中的应用最初主要是对材料进行离子质谱分析,后来由于出色的定位精度和超精细加工能力开始为其他仪器(主要是透射电子显微镜)准备精细样品,能够在数十纳米定位精度下提取特定位置并将之制备成TEM 样品。
2.FIB-SEM基本功能
FIB-SEM系统主要依靠三种基本功能实现其应用:成像、铣削刻蚀和沉积。金鉴实验室在FIB测试方面具有丰富的经验,实验室拥有一支由国家级人才工程入选者和资深技术专家组成的团队,能够针对不同的产品提供具体的解决方案。
(1)成像功能通过聚焦离子束扫描样品表面实现。当高能离子束入射到样品表面时,会与样品原子发生相互作用,产生二次电子、二次离子等信号。这些信号被探测器收集后,可形成样品表面的高分辨率图像。离子成像与电子成像相互补充,可提供更全面的样品信息。
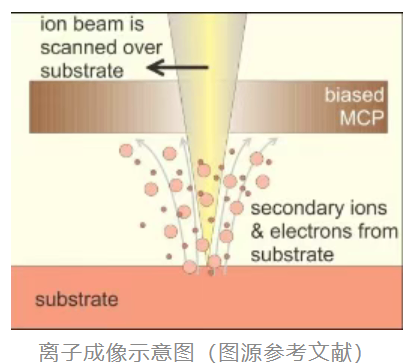
(2)铣削刻蚀是FIB的核心功能之一。高能镓离子撞击样品表面时,通过动量传递使样品原子发生溅射,从而实现材料的去除。通过精确控制离子束的扫描路径和参数,可在纳米尺度上对材料进行加工。
(3)沉积功能通过结合离子束和化学气相沉积技术实现。系统通入前驱体气体,在离子束的激发下,气体分子在特定区域分解并沉积形成金属或绝缘体薄膜。该方法可实现纳米精度的定点材料沉积
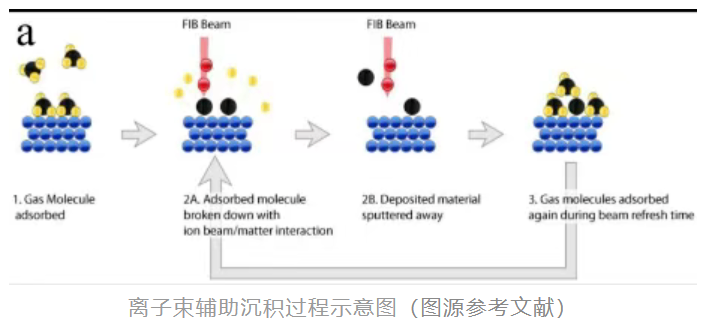
FIB-SEM 应用
1.透射电镜样品制备
透射电子显微镜对样品要求极为严格,需要将样品减薄至100纳米以下。传统机械研磨方法难以精确定位且容易引入损伤。
FIB-SEM 双束系统是 TEM 高质量制样的核心技术,能解决传统方法(机械研磨、常规离子减薄)定位难、损伤大、均匀性差的痛点,支撑原子级 TEM 分析。其核心逻辑是:用 SEM 实时成像锁定纳米级目标区域(如缺陷、界面),再通过 FIB 可控离子束“粗切 + 精切”,制备出 低损伤的超薄样品,还可搭配纳米操纵臂实现 “切取 - 转移” 一体化。
2.FIB-SEM 双束系统在微纳加工的应用
FIB-SEM系统能够直接进行微纳尺度的器件加工。通过精确控制离子束,可在材料表面加工出纳米级孔洞、线条等结构。在集成电路领域,该系统可用于修复缺陷电路、修改电路设计。此外,结合沉积功能,还可制备微机电系统(MEMS)器件、光学元件等微纳结构。金鉴实验室在进行试验时,严格遵循相关标准操作,确保每一个测试环节都精准无误地符合标准要求
测试案例分享
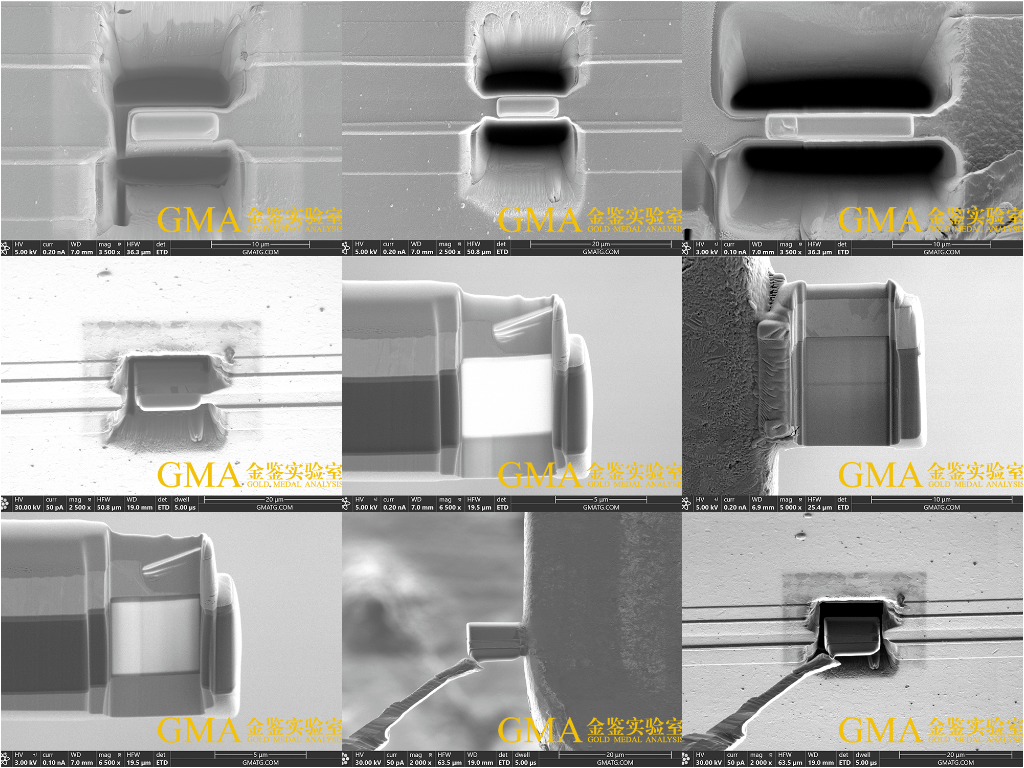
TEM制样
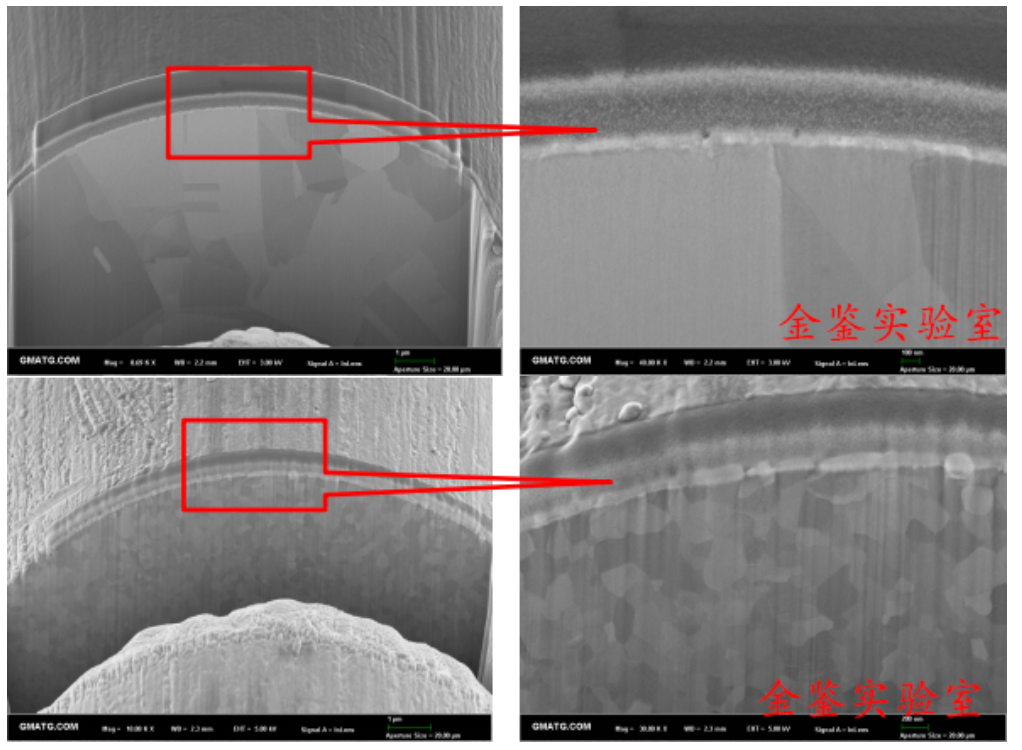
FIB切割键合线
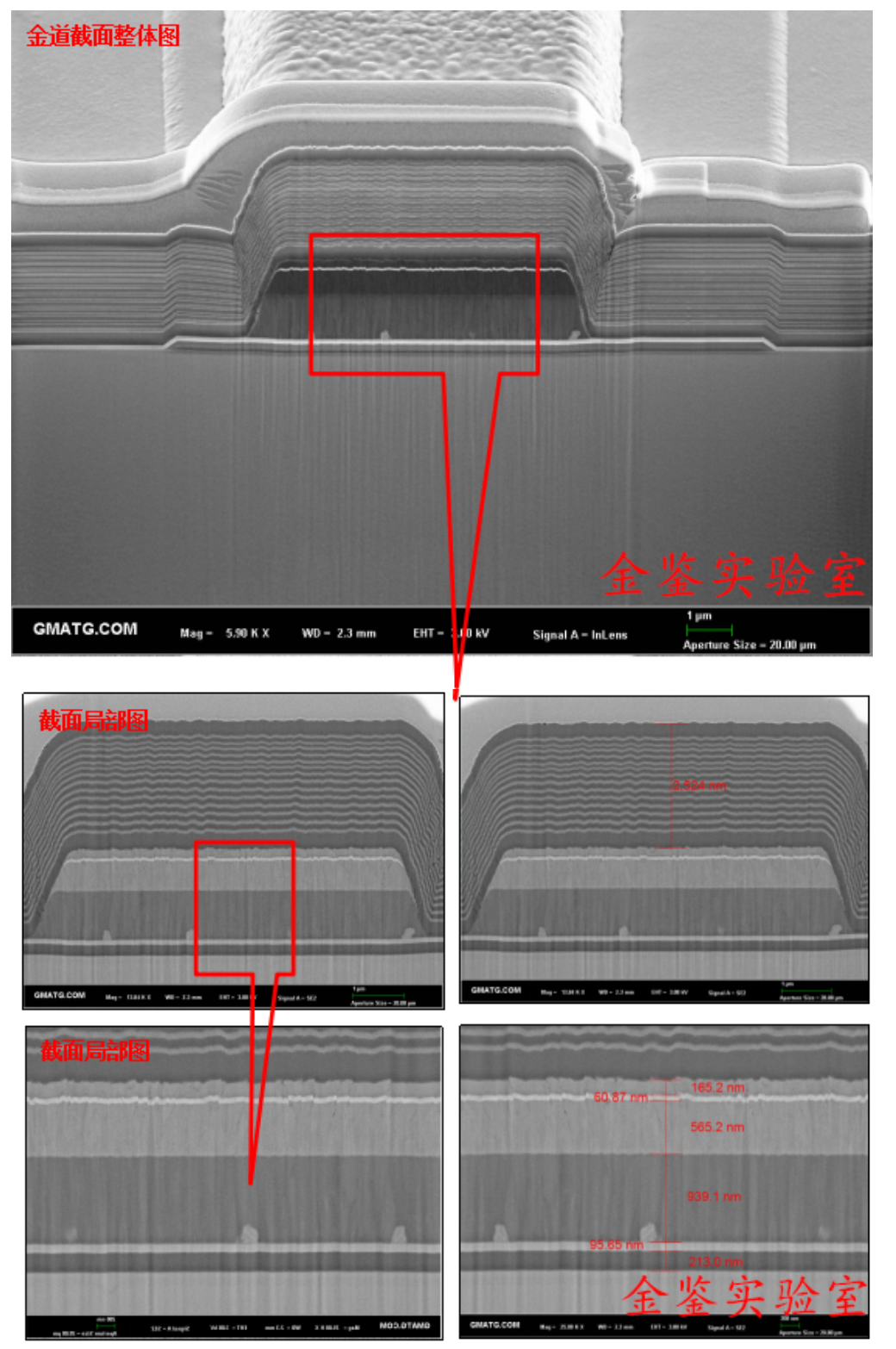
FIB切割芯片金道
FIB-SEM双束系统作为一种集成了微纳加工和高分辨率表征功能的综合平台,已经成为现代科学技术研究中不可或缺的工具。随着技术的不断发展,该系统将在更多领域发挥重要作用,推动纳米科技进步。金鉴实验室的专业服务不仅限于测试和认证,还包括失效分析、技术咨询和人才培养,为客户提供一站式的解决方案,金鉴将继续秉承着专业的服务态度,不断提升自身的技术水平和服务质量,为材料领域贡献我们的力量。
- 上一篇: 离子污染测试
- 下一篇: AEC-Q102认证之器件可焊性





