FIB与SEM/TEM联用:实现材料微观结构与成分的精准解析 发布时间:2025-09-12
为深入解析材料的“结构-组成-性能”之间复杂关联,精准高效的样品制备已成为微纳尺度表征的关键。聚焦离子束(Focused Ion Beam, FIB)作为一种高精度加工技术,有效解决了传统电子显微镜(如SEM和TEM)在制样环节面临的定位难、效率低和精度不足等问题,成为联接形貌观察与内部结构分析不可或缺的桥梁。金鉴实验室作为专注于材料分析领域的科研检测机构,能够对FIB进行严格的检测,致力于为客户提供高质量的测试服务,为材料在各个领域的可靠应用提供坚实的质量保障。
扫描电子显微镜(SEM)可用于观察材料表面形貌与成分组成,但其局限在于难以获取内部结构信息;透射电子显微镜(TEM)虽能同时对样品内部及表面的微观形貌、成分和结构进行综合分析,却需预先制备包含目标区域的超薄样品——传统制样方法往往难以满足纳米尺度下高精度定位与定向切片的严苛要求。
FIB技术能够对金属、合金、陶瓷、矿物、玻璃及有机材料等多种样品进行微纳尺度处理,制备出宽度约10~20 μm、高度10~15 μm、厚度仅100~150 nm的超薄切片。它不仅可在指定位置对纳米材料进行截面剖切,进而实现内部结构的SEM形貌观测,还可快速、精准地制备特定区域的TEM样品。
近年来,随着微纳加工技术朝着更小尺寸、更高精度不断发展,FIB已在多个领域的微结构制造与分析中获得广泛应用,成为不可替代的核心技术手段。
FIB的技术原理
FIB的基本工作原理是用加速的重离子轰击目标材料,使原子从目标材料中溅射出来。金鉴实验室拥有专业的FIB测试设备和技术团队,能够确保FIB测试的准确性和可靠性,如需进行专业的检测,可联系金鉴检测顾问188-1409-6302。
溅射过程的效率主要由离子源决定,其必须满足以下两个要求:
1.在给定的加速电压下(通常为30 keV),使用重离子以使动量传递达到最大化;
2.离子源原料的熔点和蒸气压都应很低。镓(Ga)作为低熔点金属,熔点仅为29.8°C,能够很好地满足以上两点要求,因此Ga金属被视为一种常规离子源。
在FIB操作过程中,固体Ga被加热至熔点后,液体Ga通过表面张力流动至探针针尖,从而润湿钨针。在钨尖端施加强电场后,液态Ga形成直径约2-5 nm的尖端,尖端处电场强度高达1010 V/m。在如此高的电场下,液尖表面的金属离子以场蒸发的形式逸出表面,从而产生Ga+离子束流(图1)。金鉴实验室配备多台专业的设备,能够为材料的深入研究提供了强有力的支持。
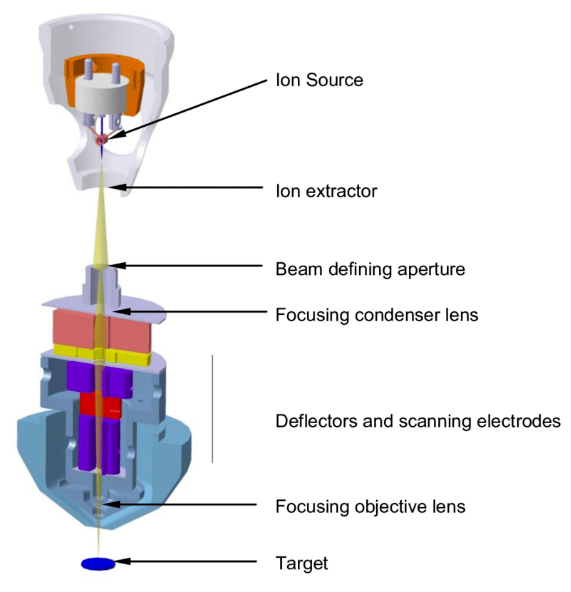
图1 FIB系统的工作原理
Ga+与目标材料的相互作用
Ga+作为带电粒子,其和电子一样与目标材料接触时会发生一系列相互作用。当Ga+离子与目标材料中原子的原子核碰撞时,会把部分能量传递给原子,使原子移位或完全脱离固体材料表面,这一现象就是溅射,FIB加工中的刻蚀功能就是依靠这一原理实现的。
此外,入射的Ga+也可能通过级联碰撞释放其动能,并在目标材料表面以下一定距离保持静止,这一过程被称为离子注入。入射Ga+与目标材料的非弹性散射产可生二次电子、声子、等离子激元和X射线。二次电子被用于成像,特别是在单束FIB仪器中,可通过连续dynode电子倍增器(CDEM)探测器收集电子。
FIB-SEM联用系统
将离子柱和电子柱组装在同一台仪器中,就形成了一种集FIB和SEM所有功能于一体的仪器,通常被称为聚焦离子束显微镜或者双束电镜,其主要作用分为两块:
1.FIB的刻蚀和沉积,可用于材料微加工、TEM样品制备、金属沉积。
2.微区成分形貌分析,兼容常规SEM的二次电子成像、背散射成像、EBSD、EDX分析等,并且双束电镜可在30 kV电压进行透射电子成像,可形成具有高空间分辨率的Z-对比度图像。
为了方便大家对材料进行深入的失效分析及研究,金鉴实验室具备Dual Beam FIB-SEM业务,包括透射电镜(TEM)样品制备,材料微观截面截取与观察、样品微观刻蚀与沉积以及材料三维成像及分析等。
FIB-TEM联用系统
由于TEM样品需要非常薄,电子才可以穿透,形成衍射图像。FIB的高效溅射可实现对样品的精细加工,因此FIB常用于TEM超薄样品的制备优化上。图3为FIB加工制备TEM超薄样品的过程。
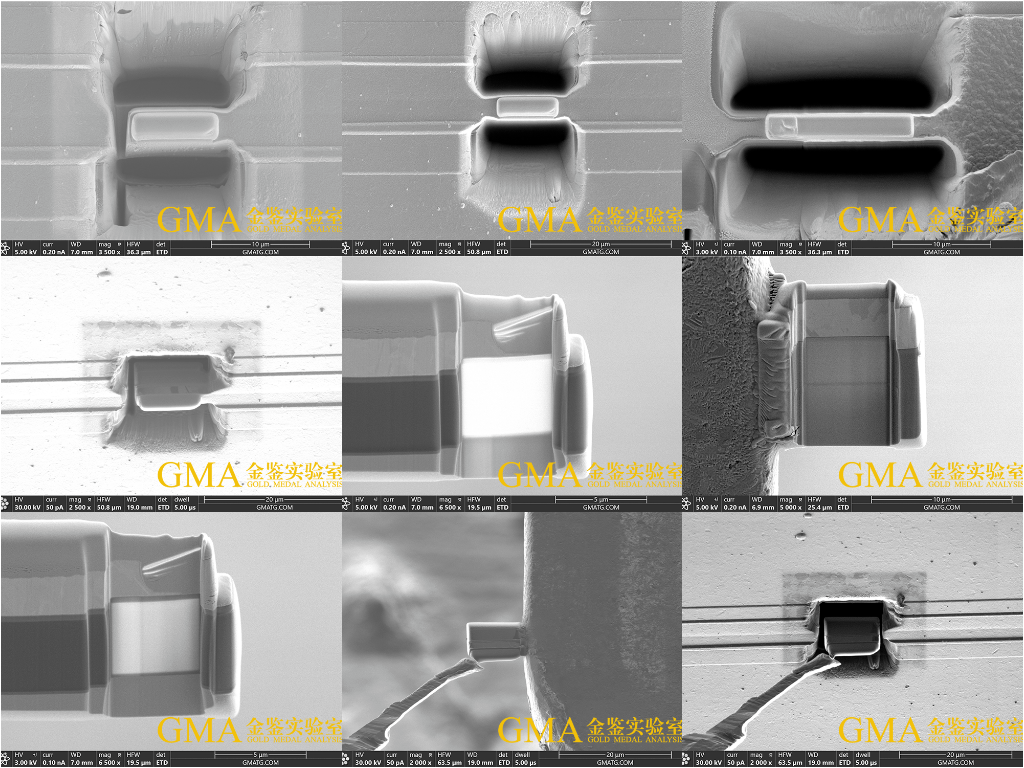
图2 基于FIB的TEM样品制备过程
FIB-SEM/TEM的应用
1.TEM样品制备优化
如上所述,制备TEM样品是FIB的一个极具特色的重要应用。与传统TEM样品制备方法相比,FIB制样方法具有以下特点:
①定点、定向精度高。定位精度小于0.5 μm 时,为唯一方法;
②几乎不用样品准备;
③制样时间短;
④制样成功率高;
⑤对加工材料不敏感,对带孔的、脆的、软/硬结合材料(如软 Polymer /金属)也可实现制样;
⑥可对同一块材料的不同区域进行特性分析。
2.FIB 微加工
微纳结构直接成形加工。直接刻蚀成形加工是FIB系统最常用的工作模式,并且从原理上讲FIB加工对待加工材料无选择性,可实现对每一个加工点深度的控制。材料沉积加工,应用FIB-SEM系统的材料沉积功能可制作纳米材料的测量电极。

图3纳米材料电极制作
指定点加工。FIB系统能灵活对样品指定点加工,比如对扫描探针显微镜SPM(如 AFM、STM)的针尖进行修饰。图5给出了AFM针尖修饰前后的照片。无论针尖为Si材料还是SiO2等材料,均能获得相似的结果。经过修饰的AFM针尖能用于一些特殊场合,如扎入生物细胞进行检测。

图4AFM针尖修饰:(a)修饰前的AFM针尖,(b)刻蚀后的AFM针尖,(c)沉积Pt后的AFM针尖
金鉴实验室的专业服务不仅限于测试和认证,还包括失效分析、技术咨询和人才培养,为客户提供一站式的解决方案,金鉴将继续秉承着专业的服务态度,不断提升自身的技术水平和服务质量,为材料分析领域贡献我们的力量。
- 上一篇: 怎么检测土壤中的重金属
- 下一篇: AEC-Q102之正弦振动





