微通孔倒装焊芯片封装失效机制与改进策略 发布时间:2024-10-18 12:07:48
本文探讨了宇航、车载和工业控制等行业数据处理需求增长,推动半导体技术向更高集成度发展。这导致半导体封装中互连点密度增加,孔径和线宽减小,而材料热膨胀系数差异引起的内部应力对互连稳定性构成挑战。倒装焊技术中,芯片与基板的微小连接点稳定性成为行业焦点。
为了提高倒装焊芯片封装的可靠性,本研究通过温度循环可靠性加速试验和有限元仿真分析,探究了倒装焊芯片在不同温度循环条件下的失效模式。研究中使用了聚焦离子束、扫描电子显微镜、能谱仪等先进表征手段,以确保对失效模式的准确识别。实验结果表明,通过改善散热盖结构,可以有效降低倒装焊封装的应力,从而提高封装的可靠性。
在实验部分,我们采用了尺寸为35mm × 35mm,厚度为1.238mm的有机基板,并对基板材料和芯片尺寸进行了详细说明。实验按照JESD22-A104D标准进行温度循环测试,测试条件分为-65 ℃~150 ℃ 500次和-55℃~125℃ 500次两种方式。通过对比不同散热盖结构的样品在温度循环测试中的表现,我们发现优化散热盖结构可以有效提高封装的可靠性。

在讨论部分,深入分析了失效模式和失效机理。通过TDR分析、3DCT分析、SEM分析和EDS分析,我们确定了基板微通孔分层是导致失效的主要原因。这些分析手段为我们提供了失效位置的精确信息,使我们能够对失效机理进行深入研究。进一步的FIB分析和有限元仿真分析表明,通过优化散热盖结构,可以显著降低倒装焊的应力,从而提高封装的可靠性。
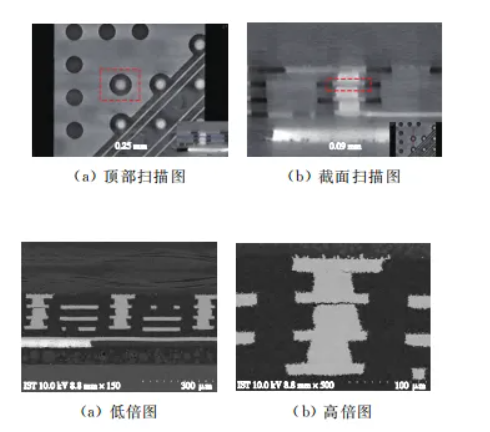
本研究的主要发现:在-55 ℃~125 ℃ 500次的温度循环条件下,所有样品均通过了可靠性验证;而在-65 ℃~150 ℃ 500次条件下,部分样品出现了断路失效。通过优化散热盖结构,成功降低了倒装焊的应力,提高了封装的可靠性,满足了高可靠性的要求。这些发现对于设计更可靠的倒装焊芯片封装具有重要的指导意义,有助于推动半导体封装技术的发展,以满足高端应用领域对高性能数据处理的需求。金鉴实验室作为国内领先的光电半导体失效分析科研检测机构,配备了先进的测试设备和严格的质量控制流程,提供Dual Beam FIB-SEM业务,包括透射电镜( TEM)样品制备,材料微观截面截取与观察、样品微观刻蚀与沉积以及材料三维成像及分析等。
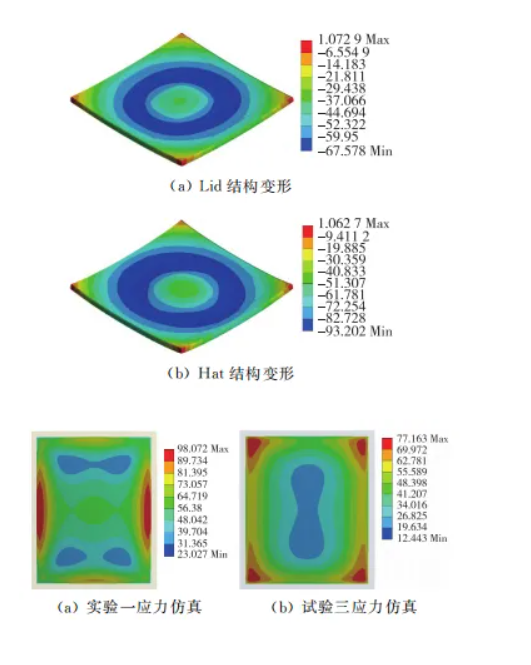
总的来说,本研究不仅提供了一种有效的倒装焊芯片封装优化方法,还为半导体封装领域的研究者提供了宝贵的实验数据和分析方法。随着技术的不断进步,我们期待未来能够开发出更多创新的封装技术,以应对日益增长的数据处理需求。






